ENEA-2 – Sputtering
In un impianto solare termodinamico parabolic trough il tubo ricevitore è uno fra i componenti a più alto contenuto tecnologico. In particolare, il coating solare, depositato sul tubo interno di acciaio del ricevitore mediante tecniche di deposizione in vuoto di tipo sputtering, rappresenta un elemento cruciale per il suo forte impatto sull’efficienza del campo solare e di tutto l’impianto.
L’impianto di deposizione “ENEA-2”, installato dal 2010 nella hall tecnologica del C.R. ENEA di Portici, è una facility di tipo prototipale ideata, progettata e realizzata per condurre attività di ricerca e sviluppo su film ottici speciali (con prospettive di applicazione commerciale principalmente nel settore del solare termodinamico) e per lo sviluppo e messa a punto dei relativi processi di fabbricazione mediante tecniche di sputtering.
“ENEA-2” è l’apparato mediante il quale sono state sviluppate, brevettate e trasferite all’industria nazionale tecnologie chiave nel settore dei coating solari selettivi a film sottili per tubi ricevitori.

Tubo ricevitore e coating solare a tecnologia ENEA fabbricato mediante l’impianto “ENEA-2”
Il design dell’impianto “ENEA-2” è proprietario ENEA. L’apparato è di tipo sperimentale (e, pertanto, dotato della più ampia flessibilità), ma ha una filosofia funzionale di tipo industriale (risulta scalabile alle dimensioni tipiche di un impianto di deposizione per produzione massiva).
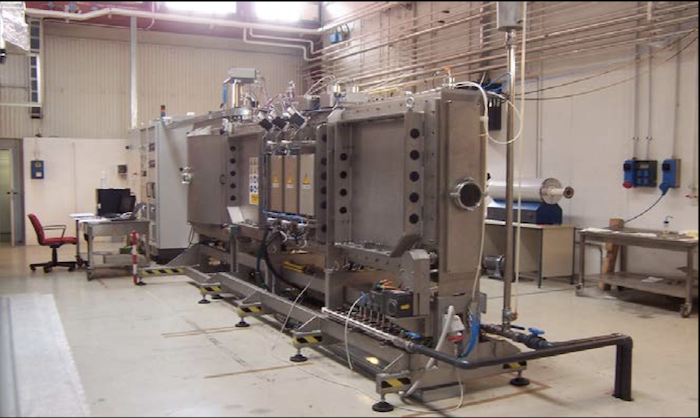
Foto d’assieme dell’impianto “ENEA-2”
Come funziona
Il layout generale dell’impianto di sputtering “ENEA-2” è definibile verticale con processi in scansione. “ENEA-2” può processare substrati tubolari di lunghezza massima di 600 mm, diametro esterno compreso fra 70 e 100 mm (tipicamente 70 mm) e spessore di parete compreso fra 2 e 5 mm. Inoltre si possono effettuare depositi su flat panel di lunghezza massima pari a 1.000 mm ed altezza entro i 380 mm.
L’impianto è costituito, fondamentalmente, da una camera load-lock (per il caricamento, lo scaricamento e per il precondizionamento termico ed in plasma del substrato), da una camera di processo (nella quale si effettuano le deposizioni per sputtering) e da un telaio inferiore di supporto. Le due camere in acciaio comunicano mediante una valvola gate di apertura pari a 150×1050 mm. La load-lock ha dimensioni approssimativamente pari a 1.300×1.300×450 mm, mentre la camera di processo ha dimensioni approssimativamente pari a 3.600×1.200×300 mm.
Nella configurazione attuale, il tubo-substrato è collocato in posizione orizzontale su di un sistema “carrello + pallet” che provvede a trasportarlo dalla camera di caricamento alla camera di processo. In camera di processo il tubo è fatto traslare e ruotare ripetutamente davanti a catodi magnetron (sorgenti di sputtering) disposti verticalmente da entrambe le parti del tubo: il processo di deposizione è dunque in scansione.

Layout generale dell’impianto “ENEA-2”
È attualmente possibile alloggiare fino ad un massimo di sei catodi montati, in gruppi da tre, su due lastre collocate da parti opposte rispetto alla camera di processo ed in posizione centrale rispetto alla lunghezza della camera di processo stessa.
La macchina è dotata, in camera di processo, sia di un sistema di pompaggio d’alto vuoto di tipo turbomolecolare che criogenico. Il pompaggio in load-lock è realizzato mediante una crio-pompa.
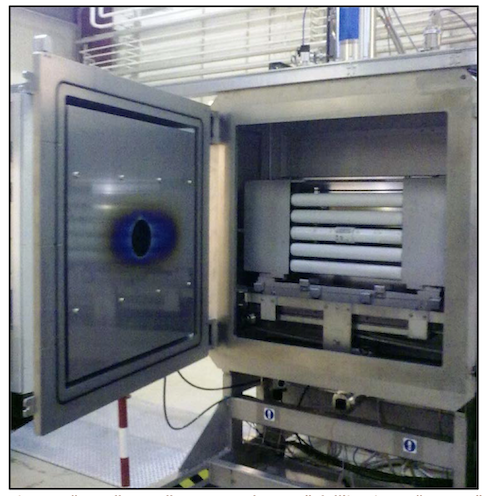
Sistema “carrello + pallet porta-substrato” dell’impianto “ENEA-2”
La camera di processo dell’impianto “ENEA-2” è attrezzata per la sperimentazione, in funzione di materiali da fabbricare, delle seguenti tecniche di deposizione:
- film metallici: DC e DC-pulsed magnetron sputtering con catodi Balanced, Unbalanced e High Strength field;
- film ceramici: MF e bipolar DC-pulsed dual- magnetron reactive sputtering;
- CERMET ovvero nanocompositi CERamico- METallici: DC-pulsed/bipolar DC-pulsed e DC pulsed/MF reactive co-sputtering;
- film a struttura e caratteristiche modificate: tecniche IBAD (Ion Beam Assisted Deposition).
I processi di sputtering reattivo ad alto rate di deposizione, che sono quelli a più difficile regolazione, sono controllabili mediante un sistema PEM (Plasma Emission Monitoring).
Possibili applicazioni
L’impianto di sputtering “ENEA-2” consente di espletare attività di:
- ricerca e sviluppo su innovativi rivestimenti multistrato a film sottili destinati principalmente, ma non esclusivamente, al settore dell’energia solare;
- sviluppo e messa a punto di processi di fabbricazione, anche di tipo industriale (alta produttività, basso costo, elevata ripetibilità e qualità di deposito), di rivestimenti a film sottili mediante tecniche di sputtering magnetron.

Processi di deposizione condotti sull’ impianto “ENEA-2”
Attività in corso
Sperimentazione finalizzata alla simulazione di processi industriali di sputtering a più alta produttività e/o con migliorata stabilità del coating solare di brevetto ENEA nelle condizioni operative del tubo ricevitore.
Attività future
Sperimentazione d’innovativi coating assorbitori solari utilizzabili a più alta temperatura rispetto allo stato dell’arte ENEA e/o per applicazioni in aria.